特点
运用高对比度,实时SEM观察和加工终点检测功能,可制备厚度小于20 nm的超薄样品
FIB加工时的实时SEM观察*2例
样品:NAND闪存
加速电压:1 kV
FOV:0.6 µm
加工方向控制技术(Micro-sampling®*3系统(选配)+高精度/高速样品台*)对于抑制窗帘效应的产生,以及制作厚度均一的薄膜类样品给予厚望。
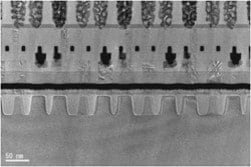 加工方向控制
加工方向控制
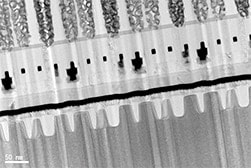 常规加工时
常规加工时
Triple Beam®*1(选配)可提高加工效率,并能使消除FIB损伤自动化
EB:Electron Beam(电子束)
FIB:Focused Ion Beam(聚焦离子束)
Ar:Ar ion beam(Ar离子束)
规格
|
项目
|
内容
|
|
FIB镜筒
|
|
分辨率
|
4 nm @ 30 kV、60 nm @ 2 kV
|
|
加速电压
|
0.5~30 kV
|
|
束流
|
0.05 pA ~ 100 nA
|
|
FE-SEM镜筒
|
|
分辨率
|
2.8 nm @ 5 kV、3.5 nm @ 1 kV
|
|
加速电压
|
0.5~30 kV
|
|
电子枪
|
冷场场发射型
|
|
探测器
|
|
標準検出器
|
In-lens 二次电子探测器/样品室二次电子探测器/背散射电子探测器
|
|
样品台
|
X:0 ~ 205 mm
Y:0 ~ 205 mm
Z:0 ~ 10 mm
R:0 ~ 360°连续
T:-5 ~ 60°
|